雙重圖形技術(shù)是將193nm浸沒(méi)式光刻延伸至關(guān)鍵尺寸<=45nm的芯片制造關(guān)鍵技術(shù)。與非線性雙重曝光技術(shù)不同,雙重圖形技術(shù)不存在材料與產(chǎn)率方面的問(wèn)題,已廣泛應(yīng)用于先進(jìn)半導(dǎo)體制造。雙重圖形技術(shù)采用不同的工藝技術(shù),通過(guò)單次或兩次獨(dú)立曝光實(shí)現(xiàn)圖形轉(zhuǎn)移。該技術(shù)可以很方便地推廣到三重或四重圖形技術(shù),但會(huì)增加成本。
光刻--刻蝕--光刻--刻蝕
通過(guò)順次進(jìn)行兩次相互獨(dú)立的光刻與刻蝕,可將密集線空?qǐng)D形轉(zhuǎn)移到基底材料上,這是最直接的方法。下圖展示了光刻--刻蝕--光刻--刻蝕(LELE)的工藝流程。該工藝目的就是在多晶硅片的氧化硅層上形成密集的線空?qǐng)D形。使用硬掩模可方便地將圖形轉(zhuǎn)移至下層。硬掩模與基底材料之間的刻蝕選擇性通常會(huì)明顯優(yōu)于光刻膠與基底材料之間的刻蝕選擇性。通過(guò)化學(xué)氣相沉積(CVD),可沉積 SiN、SiON 和 TiN 等無(wú)機(jī)硬掩模材料。旋涂碳(SOC)等有機(jī)硬掩模材料是一種含碳量很高的聚合物,可以作為備選材料,提升平坦化能力。硬掩模不僅可用于LELE中,也常用于許多先進(jìn)半導(dǎo)體制造工藝中。LELE工藝首先執(zhí)行旋轉(zhuǎn)涂膠和標(biāo)準(zhǔn)光刻工藝。光刻工藝在光刻膠中產(chǎn)生半密集圖形,然后通過(guò)刻蝕將光刻膠圖形轉(zhuǎn)移到硬掩模上。接下來(lái)將光刻膠剝離,進(jìn)行第二次圖形工藝。第二次圖形化工藝也從旋轉(zhuǎn)涂膠開(kāi)始。第二次光刻采用的掩模圖形為位置發(fā)生偏移后的掩模圖形,在剛剛形成了圖形的硬掩模上(光刻膠中)形成半密集圖形。該圖形與第一次光刻產(chǎn)生的半密集圖形會(huì)錯(cuò)開(kāi)一定的位置,將硬掩模上圖形的密度翻倍。剝離光刻膠,將硬掩模上的圖形轉(zhuǎn)移到下層的氧化物層中,完成整套工藝。
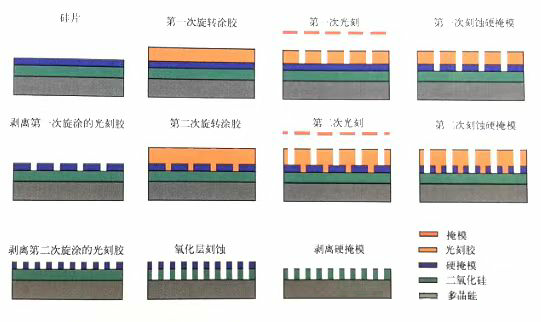
光刻--凍結(jié)--光刻--刻蝕
光刻-凍結(jié)-光刻-刻蝕(LFLE)工藝,有時(shí)也被稱為光刻-硬化-光刻-刻蝕(LCLE)或光刻-光刻-刻蝕(LLE)。與LELE相比,LFLE減少了一步刻蝕工藝,降低了成本。典型的工藝流程如下圖所示。該工藝首先執(zhí)行標(biāo)準(zhǔn)光刻工藝,形成半密集光刻膠線條圖形。與LELE工藝不同,這些光刻膠線條圖形不會(huì)被轉(zhuǎn)移到下層中,而是會(huì)被特殊處理,即凍結(jié)處理。經(jīng)過(guò)凍結(jié)處理后,光刻膠線條對(duì)第二次光刻工藝不敏感。凍結(jié)工藝用到表面固化劑或熱固化光刻膠。另外,也可以采用波長(zhǎng)為172nm的光對(duì)某些光刻膠材料進(jìn)行泛曝光,使之失去活性。凍結(jié)步驟后,在已凍結(jié)的光刻膠上再次旋涂光刻膠。對(duì)新旋涂的光刻膠進(jìn)行曝光,將偏移后的線條圖形曝光在光刻膠內(nèi),隨后顯影。第二次光刻工藝不會(huì)清除第一步凍結(jié)的光刻膠。這樣,第一次凍結(jié)住的光刻膠線條和第二次顯影后的光刻膠線條組成了后續(xù)用于刻蝕工藝的掩模。通過(guò)刻蝕工藝將圖形轉(zhuǎn)移到氧化硅層。最后剝離所有的光刻膠。LFLE 的工藝步驟比LELE 少,因此它的成本低、產(chǎn)率高,對(duì)設(shè)計(jì)的靈活性和套刻控制的需求與 LELE 相似。實(shí)際制造中,需要綜合考慮 LFLE 兩次光刻工藝之間及其與凍結(jié)步驟之間的相互影響。這些相互影響包括:第二次曝光過(guò)程中,第一次光刻形成的光刻膠圖形對(duì)光的散射,第一次光刻膠固化過(guò)程中的形貌變化;第一次光刻工藝形成的光刻膠圖形對(duì)第二次光刻膠旋涂工藝的影響;第一次光刻及固化工藝對(duì) BARC 性能的影響;第二次光刻工藝使得第一次旋涂的部分光刻膠發(fā)生脫保護(hù)和顯影反應(yīng);光刻膠之間的混合和擴(kuò)散等等。
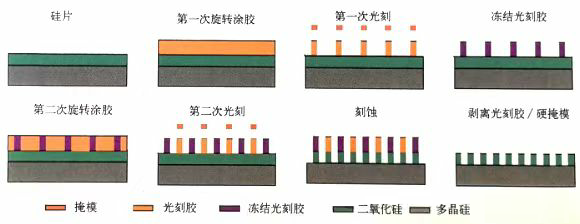
自對(duì)準(zhǔn)雙重圖形技術(shù)
如下圖所示,自對(duì)準(zhǔn)雙重圖形(SADP)技術(shù)使用光刻膠作為犧牲層,在其左右兩側(cè)生成一對(duì)間隔層。首先使用標(biāo)準(zhǔn)的光刻工藝制作半密集線條。然后,通過(guò)化學(xué)氣相沉淀(CVD)將間隔層材料(例如SiN)均地沉積到光刻膠上。隨后,采用各向異性刻蝕去除間隔層材料。除了附著在犧牲層圖形側(cè)上的材料之外,其余的間隔材料都被刻蝕清除。最后,選擇性地清除光刻膠材料,用余下的間隔層作為掩模對(duì)基底進(jìn)行刻蝕。SADP僅含一次光刻步驟,因此不會(huì)受到兩次光刻之間套刻誤差的影響。但是,間隔層材料的間距會(huì)受犧牲層圖形(也被稱為芯軸圖形,mandrel)的關(guān)鍵尺寸(CD)和側(cè)壁均勻性的影響。芯軸圖形CD的變化將改變間隔層圖形的周期,該現(xiàn)象稱為周期擺動(dòng)(pitch walking)。下圖5.所示的工藝步驟也可以應(yīng)用于具有其他幾何形狀的犧牲層圖形。沿著光刻形成的芯軸圖形的側(cè)壁形成間隔層,通過(guò)修剪曝光選擇性地去除某些間隔層圖形,可提高設(shè)計(jì)的靈活性。兩次SADP 工藝使得光刻圖形的周期進(jìn)一步減小。將第一次 SADP 形成的間隔層作為第二次 SADP 的芯軸層,可實(shí)現(xiàn)自對(duì)準(zhǔn)四重圖形(SAOP)技術(shù)。
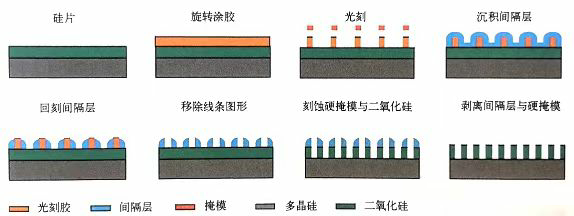
雙重顯影技術(shù)
該技術(shù)分別對(duì)光刻膠的高劑量曝光區(qū)和低劑量曝光區(qū)進(jìn)行顯影,可將圖形周期縮小一半以上。下圖描述了DTD 的基本原理。利用線空?qǐng)D形對(duì)光刻膠曝光。光刻膠中酸的濃度介于最低值(藍(lán)色)和最高值(紅色)之間;第一次后烘(PEB,圖中未顯示)觸發(fā)了脫保護(hù)反應(yīng),使得光刻膠可溶于堿性顯影液,隨后進(jìn)行第一次正顯影,形成的溝道具有與掩模版圖相同的周期。第二次顯影是負(fù)顯影,采用有機(jī)溶劑制備出位置交錯(cuò)的溝道圖形。刻蝕工藝將頻率翻倍后的光刻膠溝道圖形轉(zhuǎn)移到下層中,最后清除光刻膠。DTD 是另一種形式的自對(duì)準(zhǔn)雙重圖形技術(shù)。該技術(shù)最吸引人的一點(diǎn)是整個(gè)工藝可在涂膠顯影機(jī)上完成。與SDDP技術(shù)類似,該技術(shù)也受到設(shè)計(jì)圖形的限制。DTD 工藝的效果不僅受光刻膠材料的影響,還取決于第二次后烘過(guò)程中脫保護(hù)反應(yīng)后產(chǎn)生的形貌。第二次后烘發(fā)生在第一次正顯影之后。在第一次顯影后增加一次過(guò)曝光工藝,可以提高光酸水平,并提高第二次顯影后的光刻膠形貌質(zhì)量。雖然該技術(shù)有許多吸引人的特性,但它還僅停留在實(shí)驗(yàn)室階段,尚未用于商業(yè)半導(dǎo)體制造領(lǐng)域。
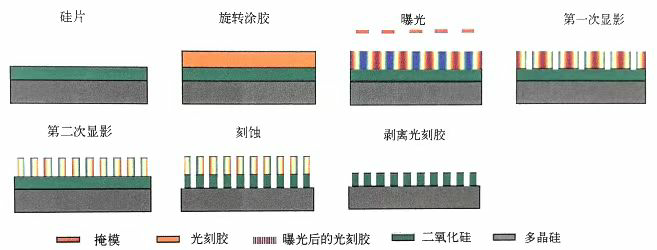
雙重或多重圖形技術(shù)的選擇
前面的例子中介紹了幾種已在半導(dǎo)體制造中獲得應(yīng)用的重要雙重圖形技術(shù)。除此之外,雙重圖形技術(shù)還包括雙極性光刻膠與自限酸擴(kuò)散周期拆分技術(shù)。不同雙重和多重圖形技術(shù)的工藝復(fù)雜度不同,對(duì)芯片設(shè)計(jì)的影響也不同。LELE 和LFLE 包括兩次光刻曝光。需要將兩次曝光的圖形準(zhǔn)確對(duì)準(zhǔn)。由于兩次光刻之間的套刻誤差會(huì)形成CD誤差,所以雙重圖形技術(shù)提高了對(duì)光刻機(jī)套刻精度的要求。盡管 LELE 和 LFLE 可以應(yīng)用于較為復(fù)雜的版圖,但版圖拆分的難度仍然很大。雙重圖形技術(shù)與光學(xué)鄰近效應(yīng)修正技術(shù)相互影響,增加了芯片設(shè)計(jì)的復(fù)雜度。相比于其他雙重圖形技術(shù),LELE需要多次光刻和刻蝕,增加了工藝時(shí)間和成本。LFLE 僅需一次刻蝕,所有工藝步驟都可以在涂膠顯影機(jī)上完成,但由于需要用到兩種不同的光刻膠,該技術(shù)增加了工藝步驟。這些工藝之間相互影響,需要準(zhǔn)確地表征并加以控制。SADP/SAQP 和 DTD都是自對(duì)準(zhǔn)雙重圖形技術(shù),它們僅需一次光刻曝光,降低了對(duì)套刻的要求。這些技術(shù)都會(huì)對(duì)設(shè)計(jì)版圖帶來(lái)一定限制,并有可能需要增加其他曝光才可以形成最終的圖形。將SADP/SAQP與剪切掩模結(jié)合使用,可用于制備邏輯電路圖形,但同樣提高了對(duì)套刻精度的要求。SADP還要求邏輯電路要采用網(wǎng)格化設(shè)計(jì),圖形只能在同一方向上。
雙重/多重圖形技術(shù)對(duì)工藝的需求和兼容性已經(jīng)得到了大量的實(shí)驗(yàn)驗(yàn)證和研究。雙重/多重圖形技術(shù)特別是SADP/SADP和LELE,已經(jīng)在先進(jìn)制造工藝中獲得應(yīng)用借助多重圖形技術(shù),DUV 光刻可以制備小于20nm 的圖形,但工藝成本也明顯增加,并提高了對(duì)套刻精度控制的要求。目前人們已開(kāi)發(fā)了適用于多重曝光/圖形技術(shù)的數(shù)學(xué)框架,可以只研究套刻控制以及套刻帶來(lái)的影響。結(jié)合雙重圖形技術(shù),EUV光刻技術(shù)可以制備特征尺寸小于10nm 的圖形,進(jìn)一步提高了先進(jìn)光刻的技術(shù)水平。